
先進封裝:後摩爾時代的關鍵戰場
當電晶體微縮的物理極限逼近,先進封裝成為延續效能提升的主要路徑。CoWoS、InFO、chiplet 架構正在重新定義半導體產業的價值分配。
目錄
摩爾定律的轉折
摩爾定律(Moore's Law)在過去 50 年驅動半導體產業的核心邏輯:每 18–24 個月,同樣面積的晶片上電晶體數量翻倍,成本下降。
但從 7nm 節點開始,這個邏輯出現結構性變化:
- 成本不再下降:先進製程的晶圓成本持續攀升(N3 晶圓成本約 N7 的 1.7 倍)
- 微縮難度指數上升:EUV 多重曝光、GAAFET 結構、背面供電(BSPDN)
- 設計複雜度暴增:先進節點的 EDA 工時與光罩層數顯著增加
在這個背景下,先進封裝(Advanced Packaging)成為延續效能提升的替代 路徑——不是把電晶體做得更小,而是把多個晶片更有效率地組合在一起。
先進封裝的三個技術方向
方向 1 — 2.5D 封裝(Interposer-based)
代表技術:CoWoS(Chip-on-Wafer-on-Substrate),台積電開發
原理:
- 在矽中介層(silicon interposer)上放置多個晶片(die)
- 晶片之間透過中介層的微細銅線互連
- 提供極高的 die-to-die 頻寬(遠高於傳統 PCB 走線)
應用:
- NVIDIA H100 / H200 / B100:HBM 記憶體與 GPU 透過 CoWoS 互連
- AMD MI300:CPU + GPU + HBM 的異質整合
- 這是目前 AI 加速器的標準封裝方式
瓶頸:
- CoWoS 產能嚴重不足:2024–2025 年 NVIDIA 的出貨瓶頸不在 GPU 晶片本身,而在 CoWoS 封裝產能
- 台積電持續擴建 CoWoS 產能(竹南 AP6 廠),但擴產速度仍趕不上需求
方向 2 — 3D 封裝(Stacking)
代表技術:SoIC(System on Integrated Chips),台積電開發
原理:
- 將晶片垂直堆疊,透過 TSV(矽穿孔)或混合鍵合(hybrid bonding)互連
- 比 2.5D 更密集,頻寬更高,功耗更低
應用:
- HBM(High Bandwidth Memory):SK Hynix、Samsung 的 HBM3/HBM3E 就是 DRAM die 的 3D 堆疊
- 未來的 CPU + cache 垂直整合
挑戰:
- 散熱:堆疊越多層,中間層的散熱越困難
- 良率:任何一層有缺陷,整個堆疊都報廢(Known Good Die 篩選成本高)
- 翹曲(warpage):不同材料熱膨脹係數不同,堆疊後容易翹曲
方向 3 — Chiplet 架構
概念:
- 不追求單一巨大的 monolithic die(良率低、成本高)
- 改為多個小型 chiplet 分別製造,再透過先進封裝整合
- 每個 chiplet 可以用不同製程(如運算核心用 N3,IO 用 N7)
標準化推動:
- UCIe(Universal Chiplet Interconnect Express):由 Intel、AMD、ARM、 台積電等共同推動的 chiplet 互連標準
- 目標是讓不同公司設計的 chiplet 可以互相搭配(類似 USB 之於外接裝置)
代表產品:
- AMD EPYC(多個 CCD chiplet + 一個 IOD)
- Intel Meteor Lake(compute + GPU + SOC + IO 四個 tile)
- Apple M2 Ultra(兩個 M2 Max 透過 UltraFusion 互連)
產業價值鏈的重新分配
先進封裝的崛起正在重新分配半導體產業的價值:
贏家
| 角色 | 代表 | 原因 |
|---|---|---|
| 晶圓代工 + 封裝整合 | 台積電 | CoWoS / InFO / SoIC 技術領先,客戶鎖定 |
| HBM 製造 | SK Hynix | HBM3E 技術領先 Samsung |
| 封裝基板 | 欣興、南亞電路板 | ABF 載板需求隨先進封裝成長 |
| 封測 | 日月光投控 | Fan-out、2.5D 封測能力 |
| 設備 | Besi、K&S | 混合鍵合 / TCB 設備需求爆發 |
輸家(相對)
| 角色 | 原因 |
|---|---|
| 傳統 OSAT(純封測代工) | 價值被台積電的前段封裝吞噬 |
| 低階打線封裝設備 | 需求被 flip-chip / hybrid bonding 取代 |
台積電的封裝護城河
台積電在先進封裝的獨特優勢:前段製程 + 後段封裝的垂直整合。
- CoWoS 的中介層本身就是晶圓製程(需要光刻、蝕刻、沉積)
- 這意味著傳統 OSAT(後段封裝廠)無法獨立提供 CoWoS
- 客戶(NVIDIA、AMD)的先進封裝需求被台積電鎖定
這解釋了為什麼 CoWoS 產能是台積電定價與客戶關係的戰略武器。
HBM:先進封裝最具象的應用
HBM(High Bandwidth Memory)是目前先進封裝最大的商業應用:
| 世代 | 頻寬 | 堆疊層數 | 容量(per stack) |
|---|---|---|---|
| HBM2e | 460 GB/s | 8 層 | 16 GB |
| HBM3 | 819 GB/s | 8–12 層 | 24 GB |
| HBM3E | 1.2 TB/s | 8–12 層 | 36 GB |
| HBM4(開發中) | 2+ TB/s | 12–16 層 | 48+ GB |
市場結構:
- SK Hynix 市佔約 50–55%(技術領先)
- Samsung 市佔約 35–40%(追趕中,HBM3E 良率問題)
- Micron 市佔約 10%(後進者但在追趕)
HBM 的需求直接連動 AI 加速器出貨量,而 HBM 本身就是 3D 堆疊封裝的產物。
台灣供應鏈的受惠結構
| 公司 | 角色 | 受惠邏輯 |
|---|---|---|
| 台積電(2330) | CoWoS / SoIC 製造 | 直接受惠 AI 封裝需求 |
| 日月光投控(3711) | 封測、Fan-out | 2.5D/3D 封測量增 |
| 欣興電子(3037) | ABF 載板 | 先進封裝需要高層數載板 |
| 南亞電路板(8046) | ABF 載板 | 同上 |
| 景碩科技(3511) | IC 載板 | CoWoS 基板供應 |
可追蹤的指標
- 台積電 CoWoS 產能 / 擴廠進度 — 法說會、DigiTimes
- NVIDIA 季度出貨量與 ASP — NVIDIA 財報
- SK Hynix HBM 營收佔比 — SK Hynix 季報
- ABF 載板價格與利用率 — 欣興 / 南電法說會
- UCIe 標準進度 — UCIe 聯盟
- 全球封測市場季度數據 — TrendForce
結語
先進封裝不是一個「新概念」,但它在 AI 時代的重要性被指數級放大。 CoWoS 產能瓶頸、HBM 需求爆發、chiplet 標準化,這三件事共同指向一個 結論:
半導體產業的下一個十年,封裝技術的重要性將逐漸接近製程技術本身。
對觀察者而言,這意味著:不要只看台積電的製程節點推進,也要看它的封裝 產能擴建;不要只看 NVIDIA 的 GPU 架構,也要看 CoWoS 和 HBM 的供給限制。
**方法論提醒:**本篇為產業技術分析,非投資建議。所有具體數字請以對應 公開資料源為準。
地緣優先的投資觀察週報
每週一封。方法論、失敗紀錄、量化驗證結果。不寄明牌,不寄投資建議。 免費訂閱即可收到精選摘要,付費解鎖完整深度研究。
- 免費版:每週 1 篇精選 + 市場速覽
- 付費版:每週 3 篇深度研究 + 數據附件
同一條思路下的其他研究
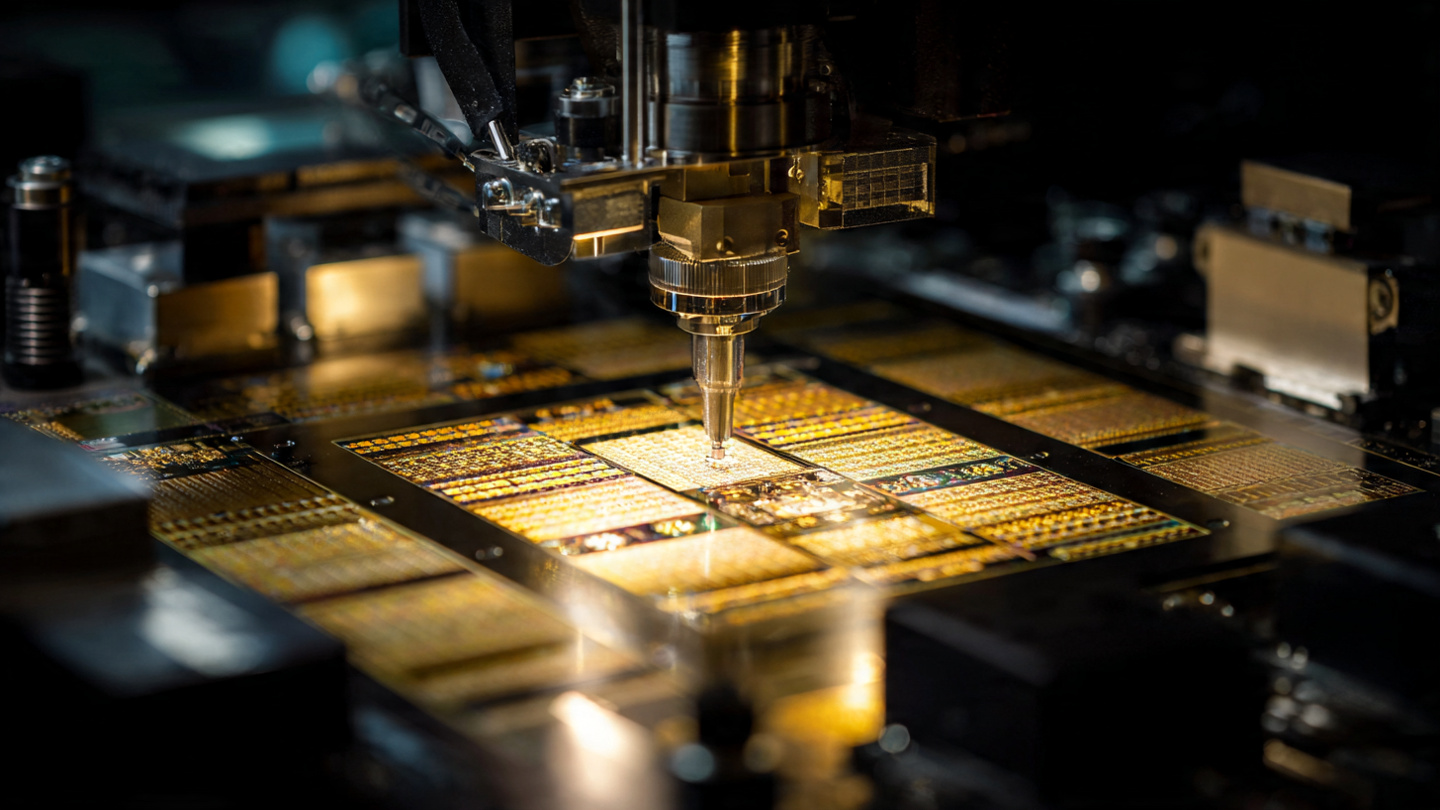
先進封裝 CoWoS:AI 時代真正的瓶頸不在前段製程
前段 3nm 量產很順,後段 CoWoS 卻成為全球 AI 晶片供應的真正瓶頸。這篇拆解先進封裝的供應鏈作戰地圖、為什麼產能擴建這麼慢、以及 18–24 個月 alpha 窗口的物理基礎。

日月光投控 3711:封測產業的後段價差結構與 2nm 量產前夜
封測長期被視為跟漲不跟跌的後段環節,但 CoWoS 與 SoIC 等先進封裝把毛利結構從中位數拉開,2nm 量產前是觀察日月光投控 3711 後段價差的關鍵窗口期,本文拆解供應鏈位置與三道觀察重點。

TSMC Q1 2026 淨利歷史新高:營收 +35%、淨利 +58% 背後的三個結構性訊號
台積電 1~3 月淨利創歷史紀錄,銷售額同比增長 35%,淨利潤增長 58%。數字遠超預期,但真正的訊號不在增長率本身,而在於毛利率加速、客戶結構質變、與美元升息的三層結構。